随着人工智能、高性能计算和数据中心应用的快速发展,高功率服务器芯片的热设计功耗(Thermal Design Power, TDP)持续攀升,已从数百瓦级迈向千瓦级水平。以当前主流服务器GPU和CPU为例,其TDP已普遍达到700–1200 W的量级。这种热负荷的急剧提升并非仅由芯片尺寸缩小引起,而是与chiplet集成、2.5D/3D封装、高带宽存储器(HBM)以及芯粒间互连等先进封装技术密切相关。在如此高的功率密度条件下,若热量不能被及时有效地扩散与移除,将直接导致性能衰减甚至器件失效。
传统的风冷技术已接近其散热极限,难以满足千瓦级芯片的冷却需求,因此液冷方案逐渐成为主流。然而,单相液冷在面对极高热流密度时仍存在明显不足,这促使研究者重新关注利用相变换热的被动式散热技术。其中,热扩散器(heat spreader)作为一种无需外部功耗即可实现高效热扩散的关键部件,长期以来被认为是高功率电子器件热管理中的重要组成。
现有技术局限:现有的大面积热扩散器多采用毛细芯驱动的蒸汽腔结构,通过液体蒸发与冷凝实现二维热扩散。这类结构虽然在一定条件下可以实现较低的热阻,但其性能高度依赖复杂的毛细芯设计和液体回流路径,在大面积、高热流密度工况下容易出现提前干涸(dryout),且制造工艺复杂、可靠性受限。
为克服上述问题,近年来提出了一种无毛细芯、依靠沸腾驱动的热扩散器(Boiling-Driven Heat Spreader, BDHS)。该结构通过受限空间内的沸腾换热与气泡泵送效应诱导内部流体循环,从而实现热量的快速横向扩散,避免了毛细芯结构带来的设计和制造限制。尽管已有研究验证了BDHS在小尺寸热源条件下的优异性能,但其在大面积、高功率芯片条件下的适用性和性能优势仍缺乏系统实验验证。
基于此,本文设计并制造了一种适用于大面积热源(645 mm²)的无芯沸腾驱动热扩散器,并围绕厚度、充液率(filling ratio, FR)和安装方向等关键参数,系统评估其热阻、最大散热能力以及热扩散性能,为下一代高功率芯片液冷系统提供可靠的被动式热扩散解决方案。


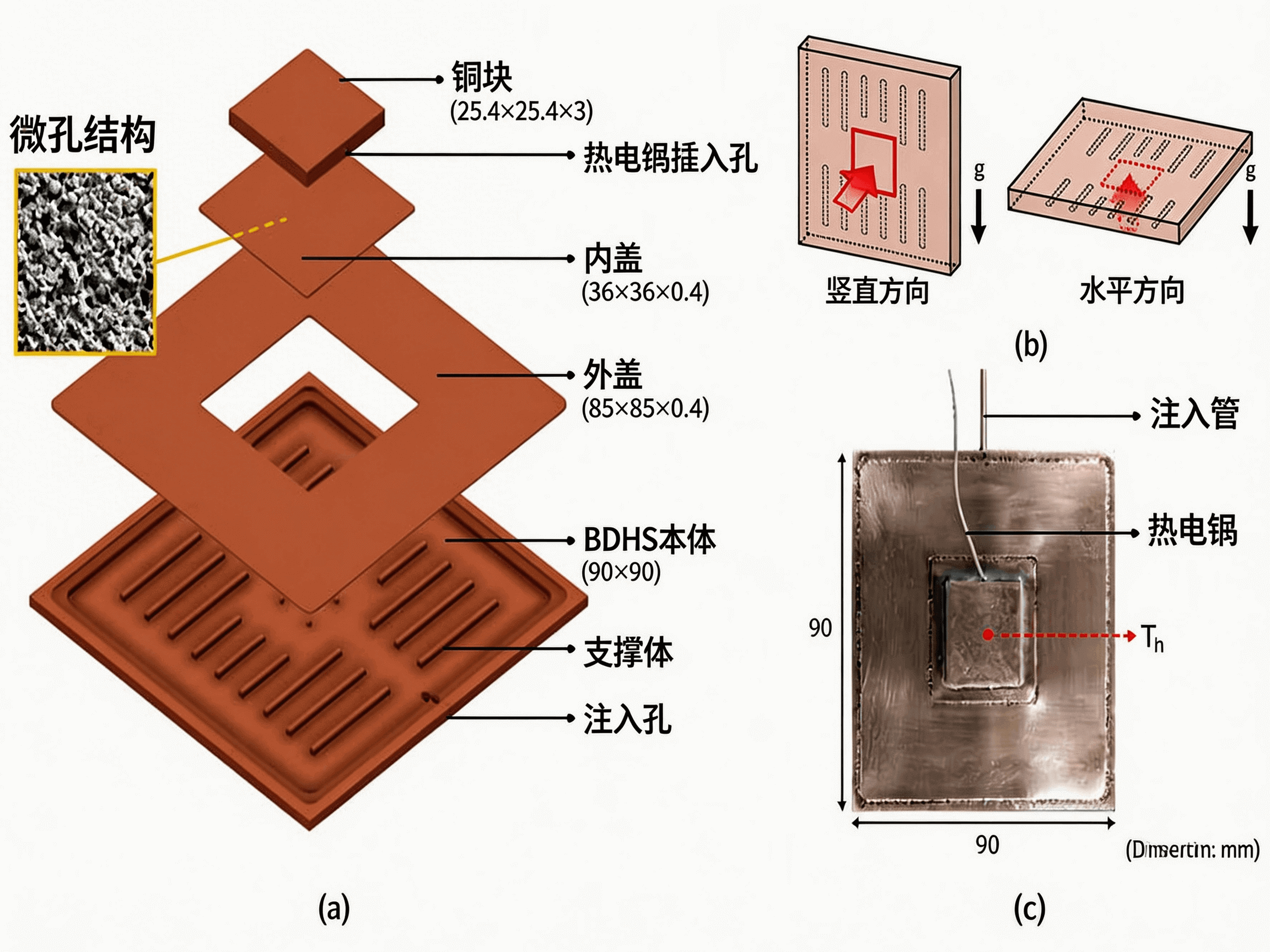
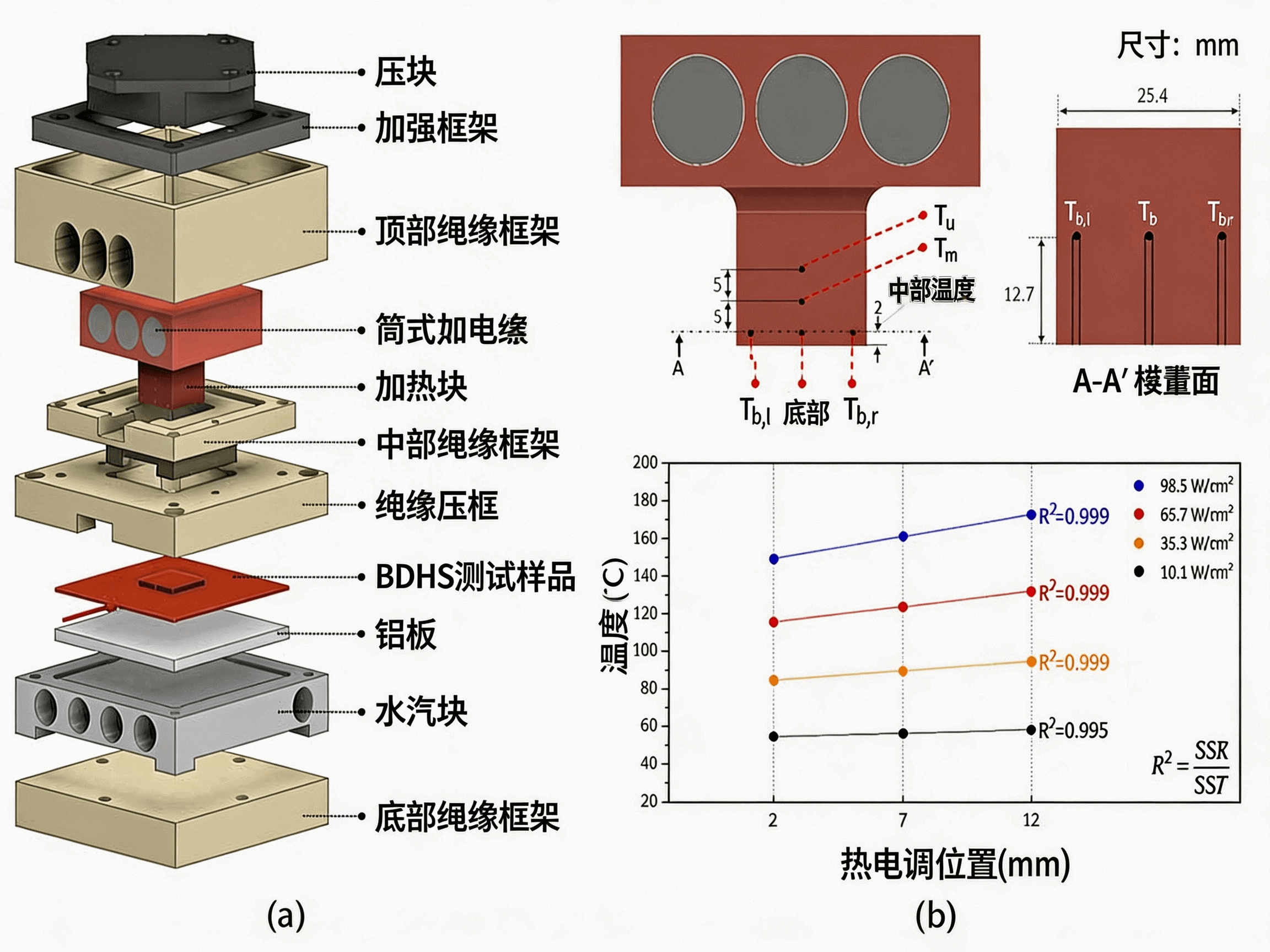
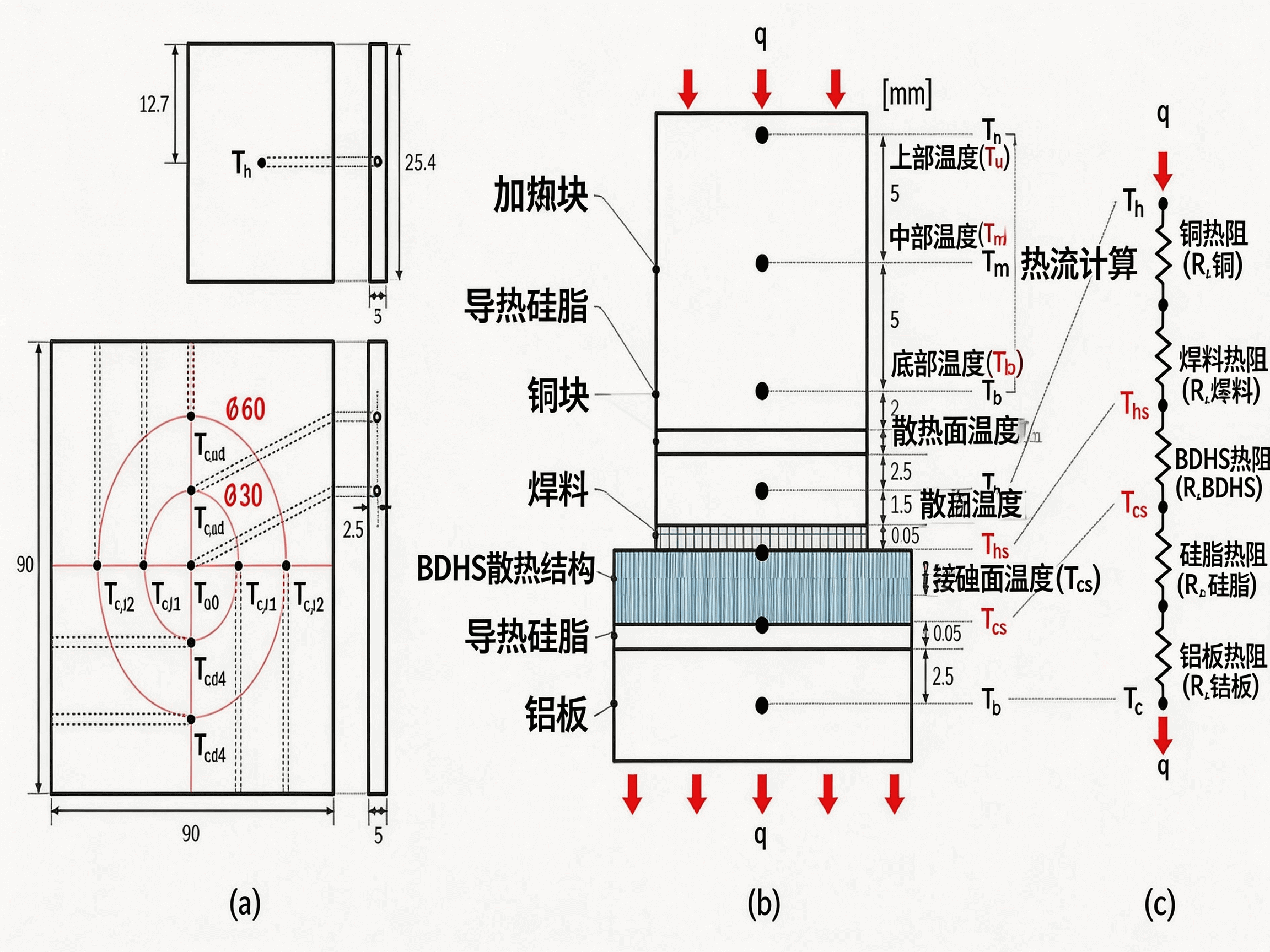
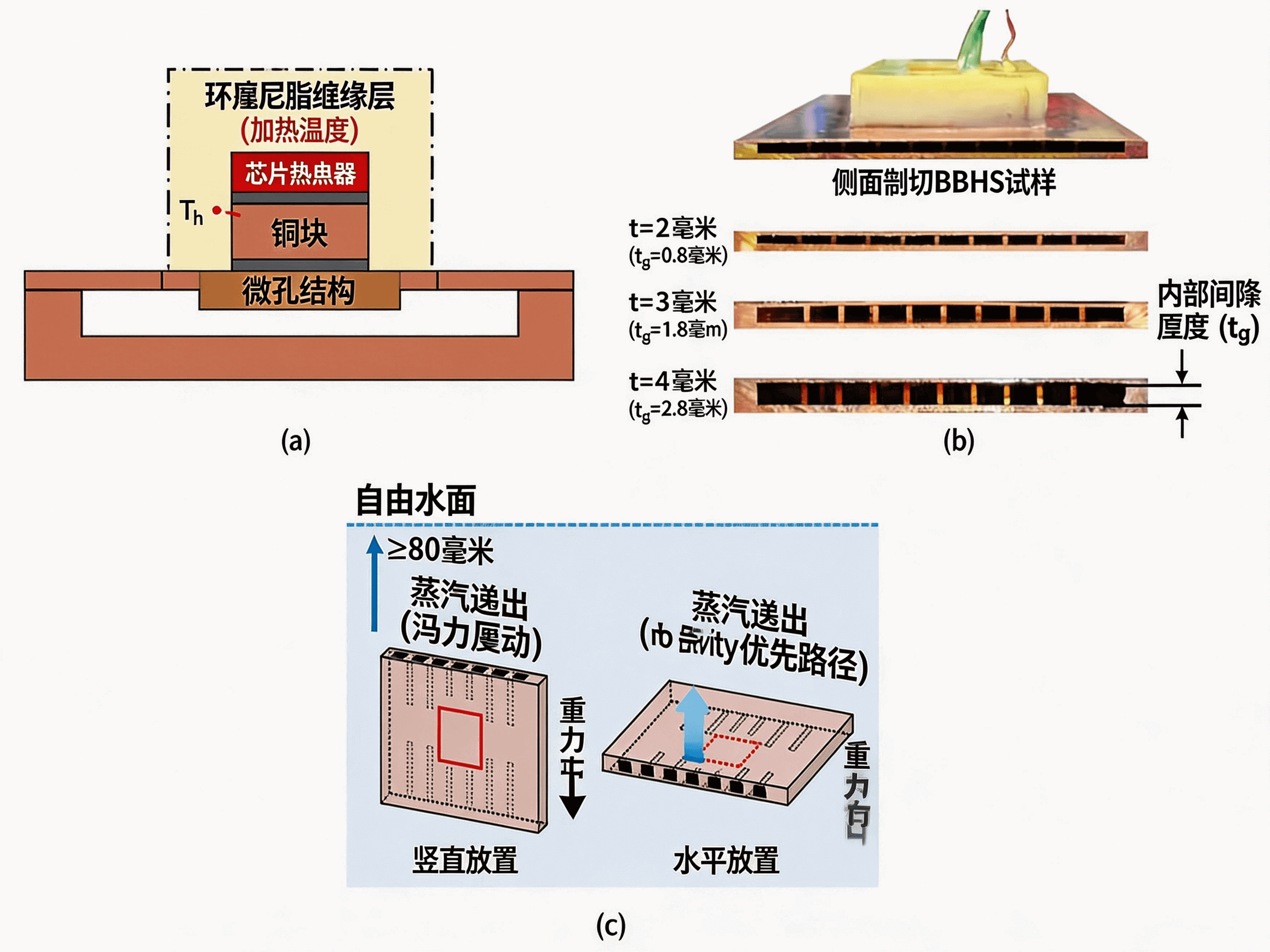
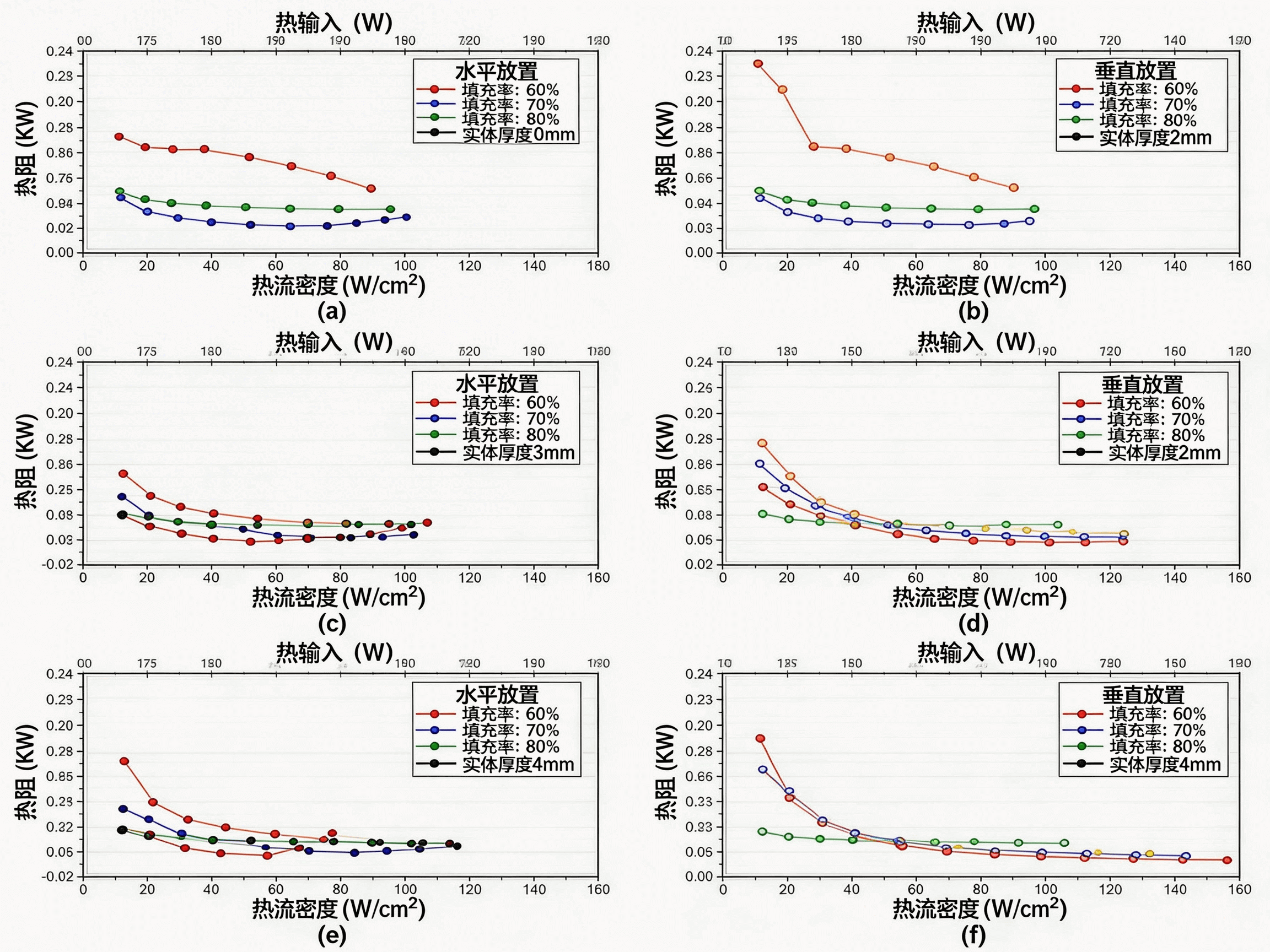


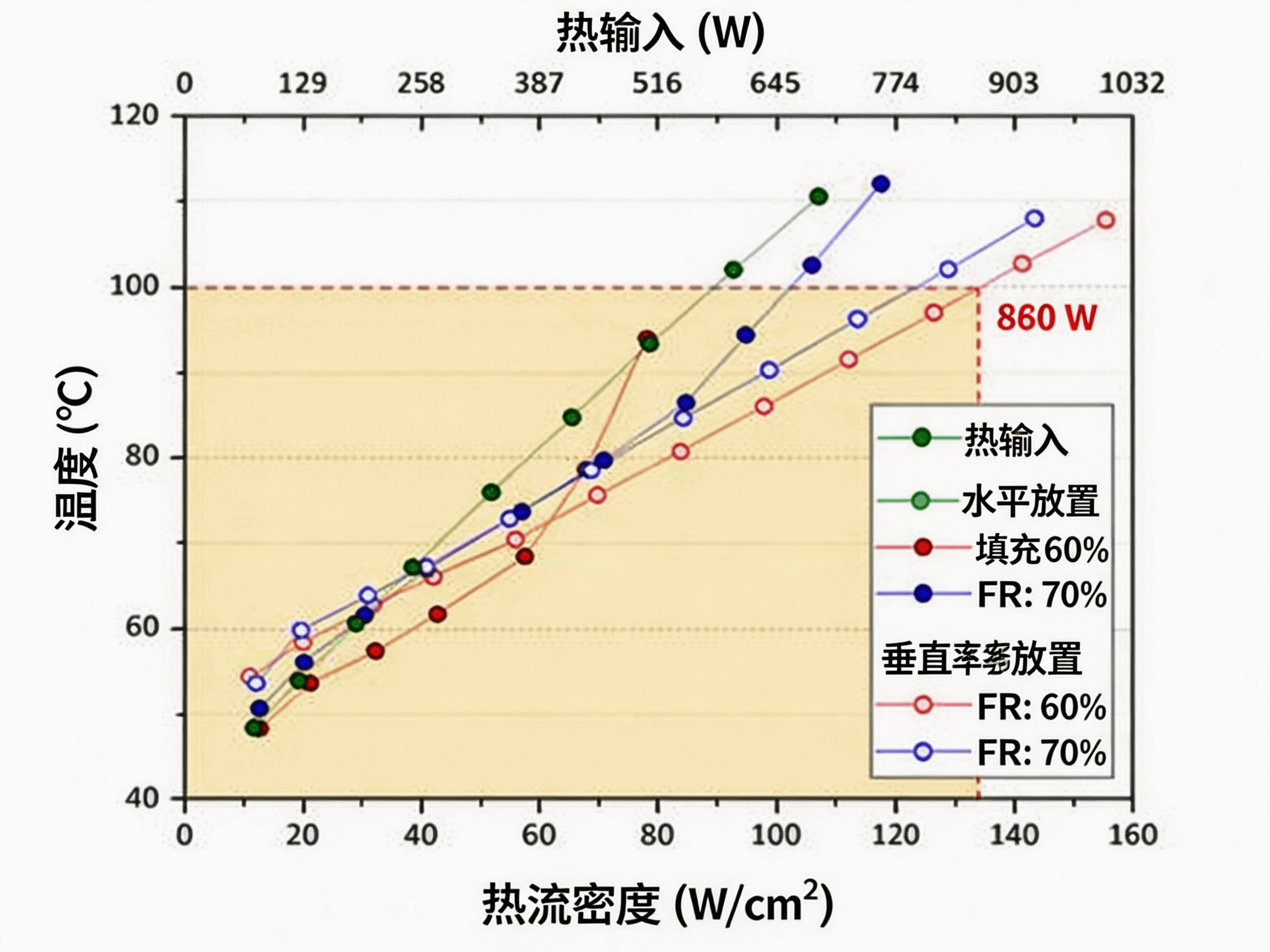

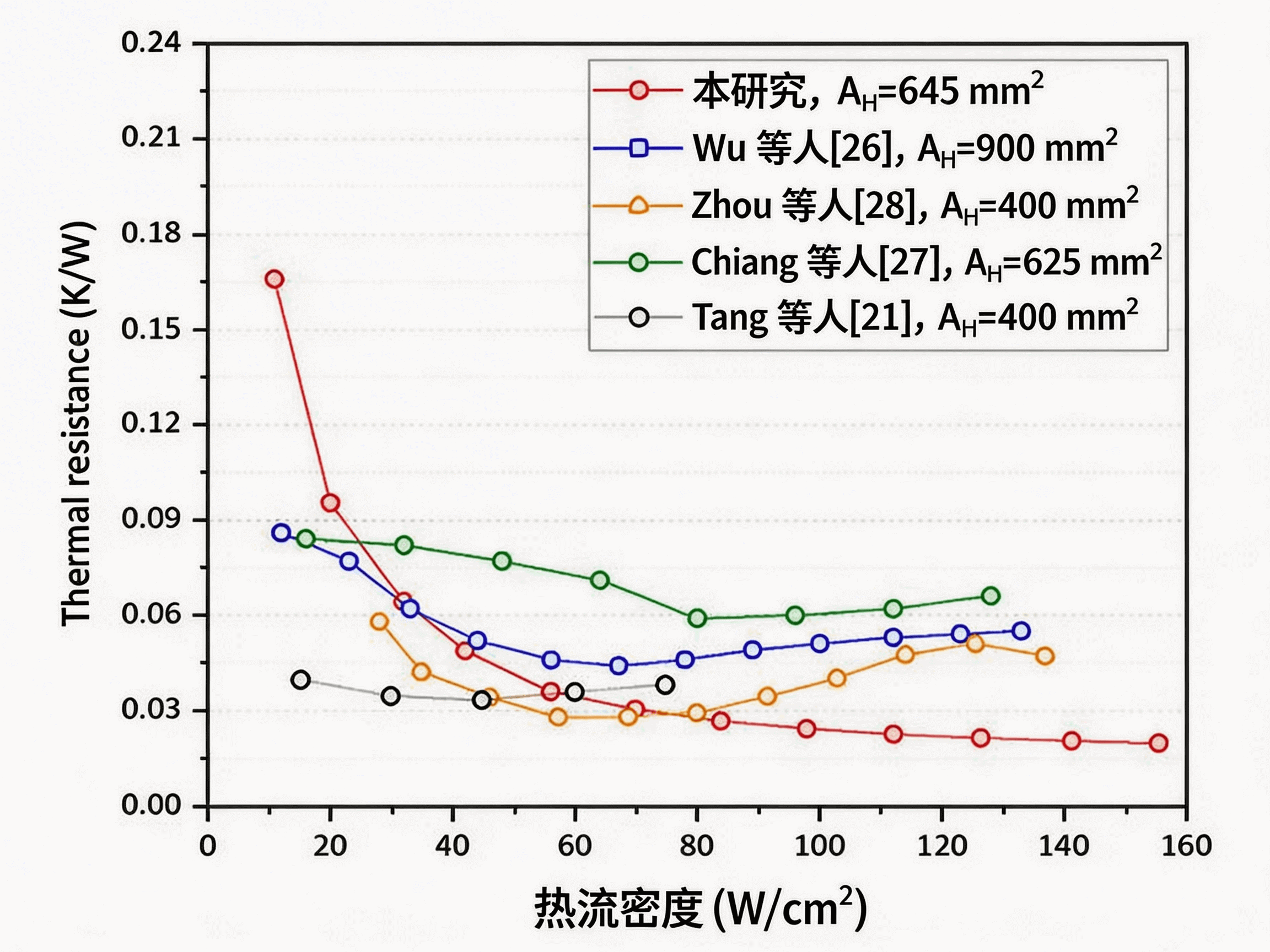
 全国服务热线
全国服务热线



 全国服务热线
全国服务热线
